一篇《Nature》论文引发芯片制造业震动
一篇《Nature》论文引发芯片制造业震动

通信行业搬砖工
发布于 2026-03-17 12:33:34
发布于 2026-03-17 12:33:34
在半导体行业的叙事里,光刻机始终是那个绕不开的关键词。我们看到光刻技术从第一代g-line到现在第五代EUV技术,每一次技术迭代都像是在珠穆朗玛的雪线往上再抬一米,空气越来越稀薄,攀登的难度成倍增长。
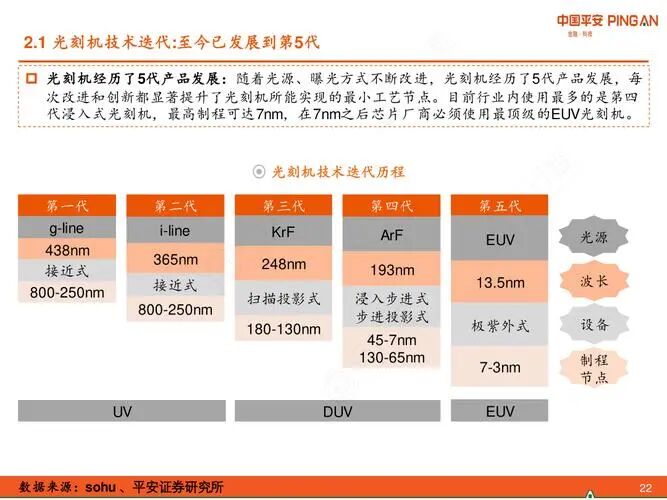
9月11日,约翰斯·霍普金斯大学团队在《Nature Chemical Engineering》上发表的一项研究,瞬间在产业圈和学术界掀起了涟漪。论文标题是《Spin-on deposition of amorphous zeolitic imidazolate framework films for lithography applications》,表面上看这只是一篇关于新型材料沉积方法的文章,实则触碰了芯片制造最尖锐的痛点:在13.5纳米极紫外光刻(EUV)已经被推向极限的今天,是否有一条新的路径,能让分辨率继续逼近5纳米甚至以下?

故事从一个新材料讲起。团队提出了一种名为无定形沸石咪唑骨架(aZIF)的金属有机薄膜,并且不是用传统的复杂真空工艺,而是用类似旋涂光刻胶的方式把它铺展在硅片上。更令人关注的是,这种材料在波长6.5纳米的软X射线范围表现出了极佳的吸收和化学响应,而这正是所谓“beyond EUV”(B-EUV)路线的关键所在。换句话说,如果EUV是行业已经踏实走过的柏油路,那么B-EUV就是远方新开辟的山间小径,陡峭,布满碎石,却可能直通更高的峰顶。
要理解这个突破的意义,必须从现行EUV的困境谈起。今天全球量产的最先进光刻机,全部来自荷兰ASML,波长13.5纳米的EUV光源采用锡等离子体,每一台设备价格超过1.5亿美元。为了继续延长摩尔定律,ASML正在推向高数值孔径(High-NA)的EUV,NA从0.33提高到0.55,理论上可以把分辨率从13纳米再压缩到8纳米左右。但问题在于,这套体系的物理极限已经浮现:光学透过率、掩模缺陷、随机噪声,每一步都在增加边际成本。即便最顶尖的晶圆厂,也需要耗资数十亿美元建造专门的洁净室和配套环境。
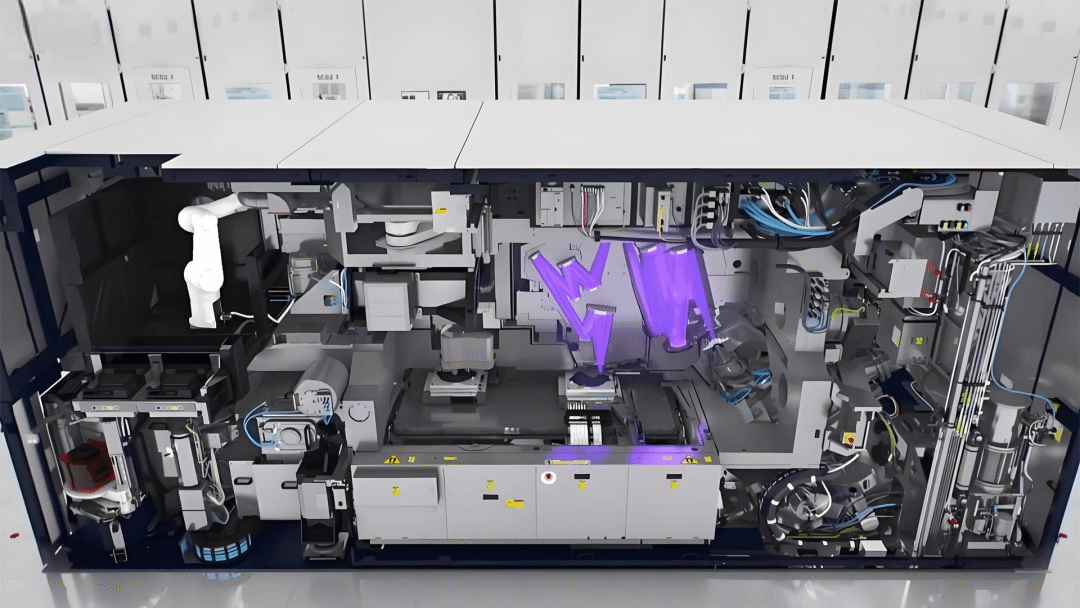
再来看B-EUV的图景。波长一旦缩短到6.5纳米,意味着在相同NA下分辨率几乎可以再缩小一半,这是任何芯片制造商都无法忽视的诱惑。然而工程师们很清楚,缩短波长不只是简单的显微镜换一块镜片。6.5纳米光源的能量损耗极大,目前能在实验室里产生的稳定光功率远远达不到量产所需。要支撑一条月产数万片晶圆的产线,需要几十甚至上百瓦稳定的光源功率,而现阶段的B-EUV光源距离这个数字至少有一个数量级的差距。没有充足的光子,就意味着吞吐量低、良率不可控,哪怕材料再完美,工厂也无法承担这种代价。
光学系统的挑战同样严苛。在13.5纳米下,产业界已经把Mo/Si多层膜反射镜的反射率做到70%左右,而在6.5纳米,理论能用的多层膜材料组合少得可怜,反射率掉到40%甚至更低。这就像一条公路每一公里都要收一半的过路费,等车开到终点时,剩下的能源所剩无几。在13.5纳米下,掩模缺陷检测已经是行业的瓶颈,而在6.5纳米,每一个原子级的突起都可能变成致命缺陷,这样就造成掩模制造和检测的问题更复杂。至于掩模保护膜(pellicle),在EUV下已经要用超薄的硅氮化膜才能勉强通过,而B-EUV几乎找不到既能透光又能耐受高能辐射的合适材料。
在这样残酷的物理条件下,约翰斯·霍普金斯的研究却在“材料”这一环按下了一个关键按钮。过去十年,光刻抗蚀剂的研究一直卡在一个“三难选择”:敏感度、分辨率、随机缺陷,三者很难兼得。EUV的常规化学体系里,光子吸收率偏低,为了达到足够的显影对比度必须提高曝光剂量,但剂量一高,就会放大随机噪声,导致线边粗糙度(LWR)超标。aZIF的思路是通过金属元素(如Zn)的高吸收截面,让短波长光子在材料中释放更多次电子,从而触发更高效率的化学反应。这在6.5纳米的实验中表现出比传统有机抗蚀剂更高的灵敏度,初步缓解了剂量和分辨率之间的矛盾。
更重要的是,这种材料的制备方式是“旋涂”,这让产业界看到了量产的希望。今天的光刻胶已经习惯了旋涂均匀铺展的工艺,而论文中展示的溶液化学沉积方法(CLD)不仅能做到纳米级厚度可控,还通过流体动力学建模把沉积速率和膜厚精确预测。这意味着实验室的漂亮结果有机会扩展到晶圆厂的大规模生产。对于半导体制造来说,这一步尤为关键,因为无论材料性能多么惊艳,如果不能在300毫米晶圆上实现均一和稳定,最终都只能停留在学术论文里。
然而,单一材料的突破,并不足以改写整个行业的格局。芯片制造是一条长链,光源、光学、掩模、抗蚀剂、刻蚀、清洗,每一环都需要同步进步。就算aZIF表现再优异,如果后续刻蚀工艺无法适配,或者在清洗过程中残留金属污染,整条工艺链都会崩塌。事实上,这些“后道兼容性”问题往往比前端突破更难解决,因为它们直接关系到良率和可靠性,而良率则是决定一条产线盈亏的生死线。
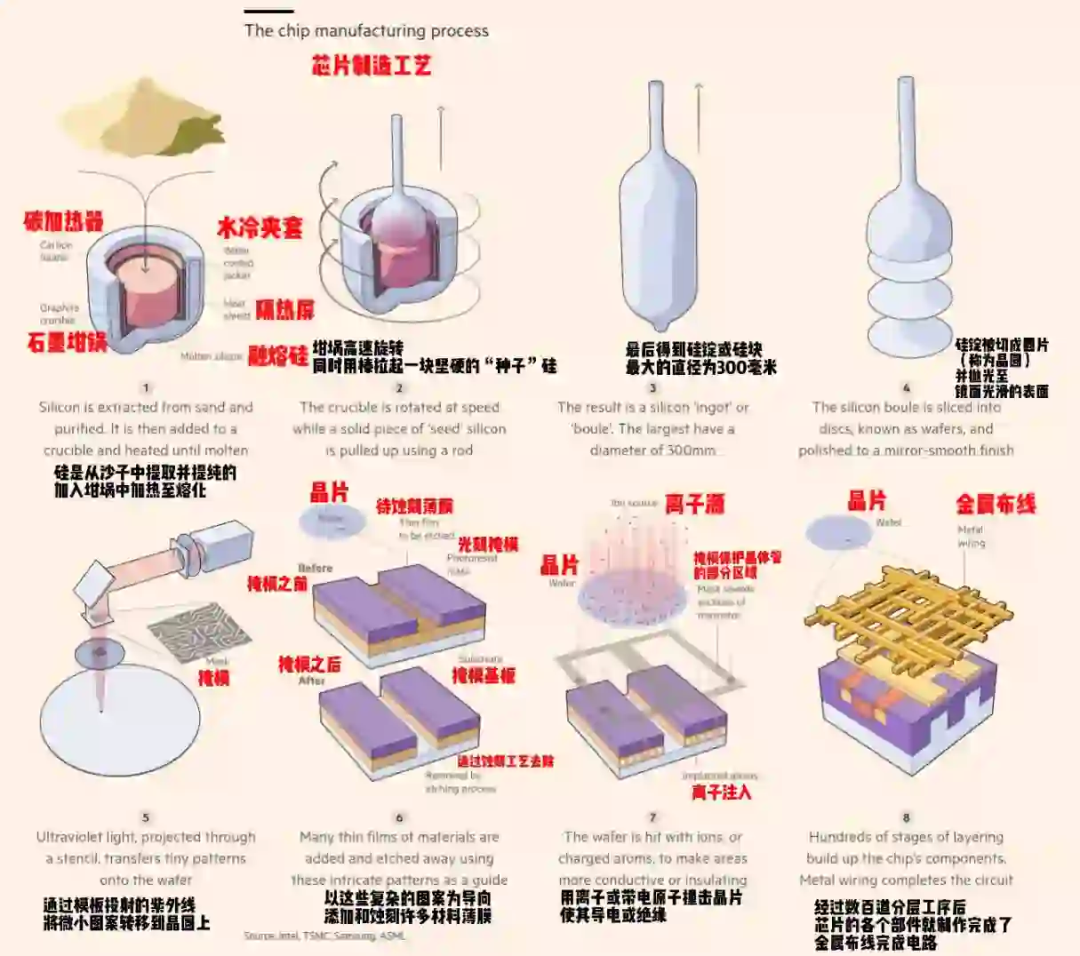
那么问题来了,B-EUV会取代EUV吗?如果从时间表来回答,短期内答案是否定的。ASML已经在2024年实现了首台High-NA EUV“first light”,并在2025年继续向晶圆厂交付。包括台积电、英特尔、三星在内的所有顶尖厂商,未来5年投资的重心仍然是High-NA EUV。而B-EUV目前还停留在材料研究和实验室曝光验证的阶段,距离建立完整的工具链差距巨大。
中期来看,B-EUV并非没有机会。它很可能成为某些关键层的补充工具。比如在AI芯片或者高性能计算芯片中,部分核心层对线宽要求极端苛刻,而其他层次仍然可以用EUV甚至ArF浸没光刻来完成。若在10年内光源和光学取得突破,B-EUV有机会在特定场景“切一刀”,不求替代EUV,而是成为高分辨率的利基技术。
长期来看,如果全套难题被逐一攻破,B-EUV不排除成为新的主流。但这一过程需要整个产业链的共同投入。光源厂商要找到高效稳定的6.5纳米辐射源,光学公司要开发高反射率的多层膜镜面,掩模厂商要能在原子级别控制缺陷,材料学界要把resist做到低随机性、低剂量容忍度,整个生态要重建一遍。换句话说,这是一场至少十年以上的系统级迭代过程。
这篇论文的意义,恰恰在于为这场迭代过程提供了一个关键筹码。它不是宣布EUV的终结,而是证明了B-EUV在材料环节的可行性。正如约翰斯·霍普金斯在官方新闻稿中所说,这是把一条潜在路线从幻想推向现实的关键一步。对产业来说,眼下更务实的态度是继续加大对EUV和High-NA的投入,同时在科研层面对B-EUV保持高度关注,把它当作下一次跃迁的备份方案。
说到芯片制造的名词摩尔定律,它并不是简单的数字游戏,而是一个个工程师用几十年的坚持不断试探物理边界的故事。每一次看似不可能的突破,都是先在实验室的曲线和图谱中闪现,然后才逐渐渗入产线。EUV曾经被认为永远不可能量产,而今天已经在全球数十条产线稳定运行。B-EUV的路同样艰难,但没人敢说它永远无法实现。aZIF材料的出现,像是在黑暗隧道的尽头点燃了一盏小灯,虽然微弱,却让人看到了另一种可能。
芯片制造的未来,不会是某一条路线独自取胜,而更像是一座多峰并立的山脉。EUV继续稳步攀登,High-NA在开辟新高度,而B-EUV则在远方的山谷里缓慢探索。最终谁能站上新的高峰,取决于谁能在物理、化学、工程、经济这四个维度同时找到答案。对今天的我们而言,能做的就是密切关注这些微小但重要的突破,因为它们可能就是未来十年行业格局转折的伏笔。
全文完,感谢阅读,如果喜欢请三连。
本文参与 腾讯云自媒体同步曝光计划,分享自微信公众号。
原始发表:2025-09-18,如有侵权请联系 cloudcommunity@tencent.com 删除
评论
登录后参与评论
推荐阅读

